字号:
A A A世界比以往任何时候都更依赖数字技术。我们使用电子设备来沟通,支持我们的工作,我们的生活正越来越走向自动化。向数字世界的转变需要支持技术,包括5G基础设施、服务器网络、移动和物联网设备、云计算、自动驾驶、金融科技等等。
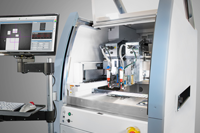
如果您是一个IDM、OSAT或OEM,并且正在不断地寻求先进的解决方案,以满足对更小、更强大的芯片的需求,从而推动新技术。
晶圆级封装:继续取得进展
晶圆级封装(WLP)是一种成熟的先进封装技术,专注于简化芯片生产过程。一般来说,WLP包括不同的集成方法,如扇入/扇出、芯片先装/芯片后装、芯片在晶圆上,以及其他一系列的封装类型。WLP是异质集成(HI)的基石,而异质集成是半导体制造业的一个关键趋势,目的是在未来提高功率、性能、面积和成本(PPAC)。HI包括晶圆级的系统级封装(SiP)架构,二维、2.5维和三维集成电路(IC)堆栈,以及最近的芯片架构应用。
面板级封装:SEMI 3D20扫清了道路
另一种先进的封装技术,即面板级封装(PLP),正在将半导体封装转向大面板格式,有望通过提高效率和规模经济来降低成本。2019年,SEMI标准3D20发布,对面板尺寸进行了标准化,为设备制造商投资开发工具以实现PLP打开了大门
与在200毫米或300毫米圆形晶圆上生产封装的WLP不同,PLP在大型方形面板上加工封装,可容纳成千上万的额外封装。例如,一个300毫米晶圆可以加工2500个6毫米×6毫米的封装,但一个600毫米×600毫米的面板可以容纳12000个封装,根据高级半导体工程公司(ASE)的说法。
WLP和PLP之间的选择可能主要在于生产的数量,PLP更适合于高产量的产品。
点胶工艺:一直发挥着重要作用
长期以来,点胶在半导体封装应用中发挥着至关重要的作用,它可以提供粘附性、结构完整性、导热性和导电性、保护性等。
随着封装技术的进步,提高点胶效率的压力也在不断增加。随着芯片数量的增加,点胶应用必须在较小的外形尺寸内,以及在芯片和组件之间的微米级间隙内,精确、一致地输送越来越少的胶体。为了提高产量和良率,高速精确点胶是至关重要的。
为此,我们不断升级着我们的产品系列,为您提供更快、更可靠的点胶解决方案。Vantage® 和Forte™ 系列点胶平台通过双阀IntelliJet®喷射点胶和先进的工艺控制,提供先进的生产效率和精度。Vortik®单螺杆泵也适用于半导体应用,无论环境温度条件或流体压力变化如何,都能提供每转固定容积的真正正排量。
Vantage系列是我们最先进的点胶平台,为高端WLP和PLP应用提供速度、精度和准确性。该系统提供单阀或同步双阀点胶,微点喷射频率高达1,000赫兹,每小时1,800,000点,窄间隙流宽<175微米,精确点胶<1.5纳升线径,以满足行业要求。它还具有扩大的工作范围,使其成为PLP应用中处理大型面板的理想选择。
在过去的几年里,我们的Spectrum® ll点胶系统一直是世界上最大半导体工厂的大批量扇出式WLP的记录工具,正如下面BBC Click采访中2:03所示。 假设你已经是一个重要的客户,并且正在运行安装在全球各地的数千个Spectrum ll点胶平台中的一个或多个。在这种情况下,除了Vantage系列之外,Forte系列是一个不可多得的升级选择,非常值得考虑。Forte系列结合了我们新一代的、经过现场测试的Spectrum ll功能,与最畅销的Spectrum ll相比,能将产能最高提升50%。
材料处理:我们已准备好提供更多的自动化服务
我们目前正在与半导体市场的领导者合作,将我们的系统与他们的高空提升运输(OHT)和自动导引车(AGV)材料处理系统整合,以推进可追溯性、熄灯工厂、工业4.0和其他未来工厂的目标。
我们的解决方案支持一系列的应用
- 封装系统(SiP
- 集成无源器件
- CoW芯片
- CoWos晶圆级封装
- BGA
- PoP
- CSP
- PCB/柔性电路
- 倒装芯片底部填充
- 倒装芯片的助焊剂喷点
- CPU/GPU盖子的密封
- 导热胶材料的点胶
- 用于盖子连接的密封

扫一扫关注
力丰集团 官方微信公众号
